解读BGA、CSP封装中的球窝缺点
跟着BGA、CSP封装器材向密距离、微型化的方向开展,无铅制程的广泛使用给Effect)缺点是BGA、CSP类器材回流焊接中特有的一种缺点形状。如图所示,焊料球和焊锡之间没有彻底熔合,而是像枕头相同放在一个窝里或一个堆上。这种缺点常常发生在BGA、CSP器材的回流焊接中,在无铅制程中更为杰出。
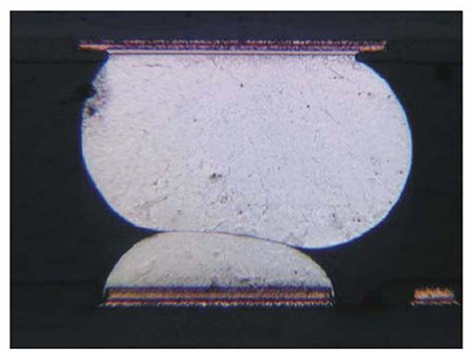
球窝缺点不易被检测出来,由于焊料球和焊锡之间往往有部分衔接。所以电路或许能够经过功用测验、光学查看和ICT测验。可是,由于焊料之间没有真实熔混,焊点不结实,或许会在后续的工艺或运用的过程中导致失效。例如,在焊接工艺之后,存在球窝缺点的PCBA或许会在后续的拼装工艺、运送过程中由于热胀冷缩或许在现场饱尝长期的电流负荷而失效。因而,球窝缺点的危害性是极大的。
2.锡膏印刷和贴片精度影响。假如锡膏印刷不均匀或不精确,或许贴片方位偏移,会导致焊料球和焊锡之间的触摸不良,然后构成球窝。
3.BGA焊球的共面性欠好。假如BGA封装器材的焊球高度不一致,会导致部分焊点受力不均匀,然后构成翘曲或开裂。
4.芯片翘曲或芯片温度不均匀,存在温差。假如芯片在回流焊接过程中受热不均匀,或许在回流焊接前后发生翘曲,都或许会导致芯片与PCB基材之间的热膨胀系数不匹配,由此发生应力和变形。这会使得部分焊点失掉触摸或别离,构成球窝。
2.选用适宜的锡膏:选用抗热崩塌才能强,去CuO(Cu2O)、SnO(SnO2)作用杰出的锡膏。
3.改进热风回流的均热才能,最好选用“热风+红外”复合加热方法,能有用改进封装体上温度的均匀性。
深圳市福英达公司自主研制和出产的SiP体系级封装锡膏Fitech siperiorTM 1550/1565,粒径T8、T9,最小印刷/点胶点φ=70/50μm,可安稳用于μBGA预置。在实践使用中体现出优异的印刷性、脱模转印性、形状和安稳坚持性及足量且均匀的印刷量。长期印刷后无锡珠、桥连缺点。
)类型 /
(Ball Grid Array)即“焊球阵列”,是在器材基板的下面按阵列方法引出球形引脚,在基板_上面安装LSI ( large Scale IntegratedCircuit
类型及结构 /
的另一个首要优势是成品率高。Motorola和Compaq等用户宣称,在其包括160至225条I/O引线英寸距离
发生。而其它的全自动工厂中,具有相同I/O引线数的细距离器材的失功率为500或100
技能详解 /
的布线长度短得多,寄生引线电容、引线电阻及引线电感均很小,然后使信号传输推迟大为缩短。
工艺的首要流程是什么 /
技能介绍 /
与反常解析 /
是现代电子科技类产品中不可或缺的一部分,它将电子元件拼装在一起,构成了一个完好的电子体系。其间,
使用特色 /
全志XR806 OpenHarmony体系入门之Hello World演示